Semiconductor
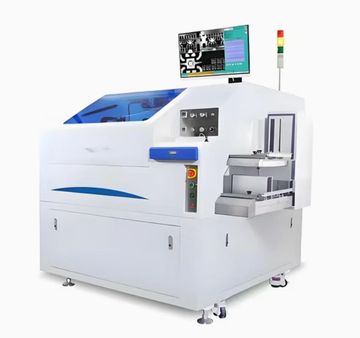
Automatic Die Bonding Flip Chip and Die Attach Bonder for Soic/So/Qfn/BGA/L
Equipment features:
DA1201FC Flip Chip and Die AttachX/Y placement accuracy:
Flip-chip/high-precision die attach mode: ±10-15μm@3σ;
Die attach mode: ±10-25μm@3σ;
Specially designed for flip chip devices with low pin count, DA1201FC provides a fully automatic high-speed flip chip solution for various devices, such as SOIC, SO, QFN, BGA, LGA, etc. At the same time, it is equipped with die attach system;
High-speed and high precision die bonding capability;

Sic Laser Annealing Semiconductor Equipment Equipped with Efem Transmission
Equipment features:
1. Modular design and integration of the entire machine, compatible with 4, 6, and 8-inch thin chip wafers
2. Integrated self-developed advanced laser shaping technology, with highly uniform and stable spot energy
3. After annealing, the surface is uniform and flat, exhibiting excellent electrical and surface morphology characteristics
4. Strictly control the oxygen content in the cavity, effectively control the amount and distribution of surface carbon precipitation

Silicon Sapphire LED Solar Wafer Laser Stealth Dicing Equipment with Dry Pr
Equipment features:
This laser wafer modification stealth dicing equipment is designed for silicon wafers, silicon carbide (SiC) wafers, LED sapphire wafers, and solar-related semiconductor wafers, supporting 4-inch, 6-inch, 8-inch, and optional 12-inch formats.
It combines an infrared laser and dedicated optics, a high-precision motion platform, CCD vision functions, and dynamic autofocus to deliver stable internal dicing performance at production speed.
Add a footnote if this applies to your business
Copyright © 2025 QuantumMate ™ - All Rights Reserved.
Powered by QuantumMate™
This website uses cookies.
We use cookies to analyze website traffic and optimize your website experience. By accepting our use of cookies, your data will be aggregated with all other user data.